L'emergere di tecnologie di processo avanzate come le interconnessioni del pilastro di rame ha spinto in modo significativo la miniaturizzazione tridimensionale di moderni dispositivi elettronici e i miglioramenti delle prestazioni accelerati nelle apparecchiature correlate. Tuttavia, questo progresso ha introdotto sfide nell'analisi dei fallimenti per le tecnologie di imballaggio avanzate. Per le applicazioni di imballaggio avanzate, la localizzazione dei guasti può richiedere profondità di elaborazione superiori a 100 μm, in cui il tradizionale raggio ionico focalizzato su ioni di gallio (GA⁺) lotta per ottenere una rapida localizzazione dei difetti.
Questa limitazione sorge perché Ga⁺ FIB opera a una corrente di fascio massima di ~ 100 Na sotto 30 keV, che richiede decine di ore per elaborare un'area di 500 μm². Al contrario, il FIB plasmatico (PFIB) utilizza gli ioni xenon (XE⁺) come sorgente ionica, fornendo una corrente di raggio massima di ~ 2,5 μA a 30 keV-over 20 volte più efficiente del FIB GA⁺. Questa svolta consente a PFIB di superare il collo di bottiglia del tradizionale FIB GA⁺: rapida elaborazione in grande area.
Casi studio di applicazione PFIB
① Morfologia della sezione trasversale TSV e analisi dell'orientamento al cristallo EBSD
Sfruttare la capacità di sezione trasversale di grande volume ad alta velocità di PFIB, l'analisi di morfologia trasversale rapida e precisa può essere eseguita sulla struttura critica attraverso il VIAS-silicon (TSV) in una struttura critica 2.5D\/3D avanzata. Allo stesso tempo, l'analisi dell'orientamento cristallino della sezione trasversale può essere condotta utilizzando una sonda esterna di diffrazione di backscatter di elettroni (EBSD), come illustrato nella Figura 1.
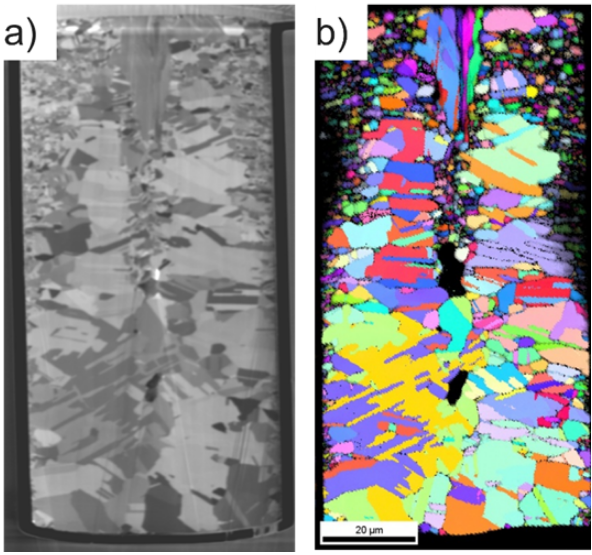
*Figura 1. A) Immagine SEM in sezione trasversale di TSV (attraverso il silicio via), una struttura chiave nella confezione avanzata 2.5D\/3D;
b) analisi EBSD (mappatura IPF-Y) (immagini per gentile concessione: Thermo Fisher Scientific).*
② Preparazione del campione TEM ultra-sottile in grande area per NAND 3D (campionamento Planview)
Un'altra funzione critica di PFIB è la preparazione di campioni di microscopia elettronica a trasmissione ultra-sottile ad grande area (TEM). Grgtest ora raggiunge la preparazione del campione TEM specifica del sito con lunghezze e larghezze superiori a 50 μm, soddisfacendo i requisiti per l'osservazione TEM di risoluzione atomica.
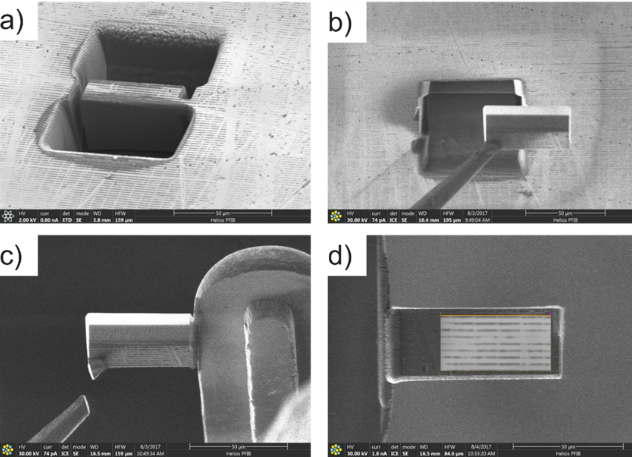
*Figura 2. Flusso di processo per la preparazione del campione TEM ultra-sottile ad grande area (campione: NAND 3D; dimensione dell'estrazione di Planview ~ 50 μm)
a) macinazione della trincea; b) sollevamento ed estrazione; c) trasferimento alla griglia TEM; d) diradamento finale.*
Funzionalità di servizio PFIB GRGTEST
Il sistema PFIB del laboratorio di test e analisi WUXI IC di Grgtest è il sistema PFIB 5 all'avanguardia di Thermo Fisher Scientific Helios 5, attualmente la piattaforma XE-FIB più avanzata sul mercato. Raggiunge una risoluzione di imaging SEM inferiore a 1 nm, con prestazioni e automazione del raggio ionico ottimizzate rispetto al suo predecessore (Helios G4 Dualbeam). Equipaggiato con una sonda di nanomanipulatore, sistema di iniezione di gas (GIS) e sonda di spettroscopia a raggi X (EDX), il PFIB di Grgtest soddisfa le esigenze di analisi di fallimento di semiconduttori fondamentali e avanzate.
